

范德瓦尔华(vdW)层状材料的可扩展生产和集成技术对其在下一代纳米电子学中的应用至关重要。在现有的方法中,受欢迎的可能是原子层沉积(ALD),因为它具有自限制逐层生长模式。然而,ALD生长的vdW材料通常需要较高的加工温度和/或沉积后额外的退火步骤来结晶。此外,ALD生产的vdW材料的缺乏针对特定材料的定制工艺设计而受到相当的限制。在这里本文在低至50°C的温度下,使用合理设计的ALD工艺,实现单元素碲(Te)薄膜的无退火晶元尺度的生长。这种生长工艺所使该薄膜表现出异常的均匀性/结晶度,精确的层可控性和100%的步长覆盖。分别与二硫化钼和n-Si的vdW异质结和混合维垂直p-n异质结,具有明确的电流整流和空间均匀性。此外,我们还展示了一个基于ALD-Te的阈值切换选择器,它具有快速切换时间(~40 ns)、选择性(~ 104)和低Vth(~ 1.3 V)。这种合成方法可以在低热下生产vdW半导体材料,为单片集成到任意3D器件结构提供了方法。
展示全部 
拉曼在ALD生长特定材料的定制工艺中的应用
引言:二维(2D)范德瓦尔斯(vdW)材料由于其特殊得材料厚度呈现出很多优异得性能,包括过渡金属双卤化合物(TMDs)和被称为Xene(X为Ge、P、Te等)的二维半导体在内,催生了大量相关主题的研究。由于其优越的载流子迁移率和在原子尺度厚度上的有效静电栅能控性,TMDs和Xene将是下一代电子领域很有前途的候选者。然而当前二维材料的合成技术依旧面临技术挑战(例如,晶片规模均匀性,可靠的批量生产和不影响结晶度的较低的合成温度),高保质量合成和包括硅基其他2D材料的异质材料合成方法,是解锁这些材料的潜力在科学和技术领域的必要途径。
目前原子层沉积(ALD)由于其特殊的厚度均匀性/可控性,广泛应用于半导体制造中沉积非晶高k介质,,成为一种理想的薄膜生产技术。低温制备,和优良的步骤能够覆盖任何的非平面几何器件。因此,将ALD的技术成为制备2D vdW材料有前途的方法。然而,原子层沉积的2D(ALD-2D)材料通常需要较高的加工温度和/或沉积后退火(PDA)来进行结晶。例如,一种具有代表性的2D材料-由ALD制备的MoS2-需要在高温下进行PDA处理,范围从450到900℃;这与整合3D以及线后端工艺不兼容。此外,如微米大小的薄片和纳米片非连续的形态,也经常在ALD-2D材料中观察到的,这是硫质化诱导的热解析的结果,这限制了它们在实际中电子应用。
近年来,由vdW键合螺旋链组成的vdW晶体碲(Te)引起了人们的广泛关注。虽然它表现出类似于厚度依赖的电子性质,但它依旧具有很好的物理性质,如强自旋-轨道耦合,环境增强稳定性,和相对较低的晶格热导率。此外,Te的潜力可以广泛应用于(光)电子学、自旋电子学、热电学、和选择性器件,其p型输运行为、强大的手性、较强的热电性能和快速开关性能均很出色。由于其独特的性能,由于Te在高温下会发生热扩散和解析,所以必须开发一种薄膜定制生长技术,以解决相关问题。迄今为止,多种方法如物理热相沉积技术,包括热蒸发、溅射、和脉冲激光沉积,都被专门用于Te沉积生长。
在此,我们报道了一种在接近50℃的室温下,通过合理的无退火ALD工艺,原子层沉积了碲(ALD-Te)薄膜。我们利用了两种前驱体-Te(SiMe3)2和Te(OEt)4,采用协同策略,结合(i)引入甲醇(MeOH)来提高初始吸附/成核密度,(ii)重复给药技术来Min化空间阻断效应。使用上述方法,沉积的ALD-Te薄膜显示出晶元级的均匀性(受仪器的限制达到4英寸)、多结晶度和优良的步长覆盖度,表面覆盖接近100%。zui后,我们研究了它们的电性能,通过(i)垂直p-n异质结二极管进行电流整流和(ii)典型的应用,基于ALD-Te的选择器件,将其评级为电子级vdW晶体。
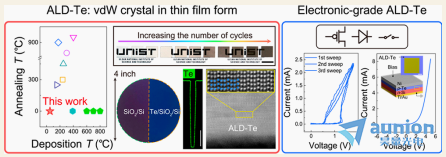
图1:实验流程和结果示意图
图1a展示了这种淋浴喷头式反应堆生成vdW Te薄膜的生长的示意图。在低沉积温度下用两种液相Te前驱体-Te(OEt)4和Te(SiMe3)2做促进反应,对于共价键合的元素薄膜同样如此,如ALD 生长的Sb。
如图1b所示,与左半部分裸衬底进行比较,通过定制的ALD工艺,我们成功地实现了在50℃下,Te薄膜在4英寸尺寸SiO2/Si晶元上晶元级生产。在此我们进行拉曼光谱和作图表征来评价薄膜的质量和均匀性(AUT-Nanobase-XperRamS)。图1c是ALD-Te的典型拉曼光谱,在141、122和2325px-1处分别表现出相应的E2、A1和E1振动模式。三种振动模式与晶体Te的振动模式一致,表明链内共价键和vdW耦合的连间键形成良好。共聚焦拉曼mapping是在整个元片上选取20个分散的具有代表性局部区域图进行检测,检测条件为单个面积为20μm×20 μm,步进为1μm。E2和A1模式的合并图显示了在晶元尺度上良好的均匀性和合成Te的完整覆盖性(图1b)。还有,我们进一步检测了与厚度相关的拉曼响应,以确定ALD-Te的vdW特征。A1(链间振动)和E2(链内振动)模式在厚度减小时均表现出明显的蓝移,这种行为可以归因于薄膜中Te原子恢复力的增强和层间长程库仑相互作用的增强。这组拉曼数据说明,尽管没有热退火,甚至沉积温度比其他报道的ALd-2D材料生长温度更低(图1d),ALD-Te依旧可以生长成高度有序晶体,从而打破因为高温生长或高温退货而无法实际应用的限制。
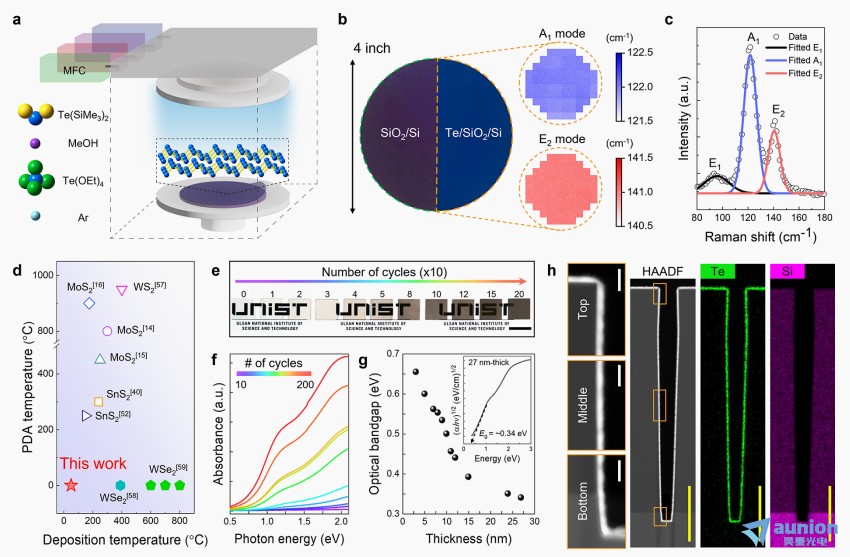
图2:ALD-Te的可伸缩性、可控性和同质性。(a)用于生产Te薄膜的淋浴喷头型ALD反应器的示意图。两个Te前驱体、共反应物(MeOH)和标准载体/净化气体(Ar)分别通过质量流量控制器(MFC)单独连接。颜色编码:黄色,SiMe3配体;绿色,OEt配体;蓝色,Te原子;紫罗兰色,甲醇分子;天蓝色,Ar分子。(b)的4英寸的照片。在SiO2/Si衬底上沉积的晶片级Te薄膜以及A1(~3050px-1)和~3525px-1)的e2的相应的空间拉曼映射。(c)ALD-Te的代表性拉曼光谱(532 nm激光激发)。(d)ALD-2D材料如MoS2、14?16WS2、57WSe2、58、59和52的沉积和PDA温度基准图,52开放和封闭符号分别表示是否进行PDA过程。(e)随着循环次数的增加,在熔融硅衬底上的薄薄膜的光学图像。比例尺:2厘米。(f,g)(e)中所示的Te薄膜的紫外-可见吸收光谱和提取的光学带隙。(g)的插图显示了27 nm厚的ALD-Te薄膜的代表性Tauc图。(h)在高长径比为1:12的深沟槽结构上的ALD-Te薄膜的横截面HAADF-STEM和EDS元素映射图像。白色比例尺,50 nm;黄色比例尺,600 nm。
在本研究中,通过设计的无退火低温(50℃)ALD工艺成功地证明了单元素二维Te薄膜具有特殊的晶元级均匀性、共形性和结晶度,以及可调的厚度。ALD Te薄膜的这些特点是通过引入甲醇MeOH和重复给药技术来实现的,这两个条件使Te从岛状结晶到薄膜生长。有趣的是,通过实验结果还揭示了MeOH的双重作用,即吸附位点的激活和配位紧化,这与DFT模拟非常一致。此外,ALD Te薄膜作为一种电子元件,能够被用于垂直p-n异质结中的p 型构建块和一种典型的无混合选择器件中。这项研究将有助于基于ALD的范德瓦尔华电子学的发展,融合晶元级的单片3D集成和ALD技术能够催生出一系列包括纯元素的vdW层状材料的材料。
文章信息:该成果以“Atomic Layer Deposition Route to Scalable,
Electronic-Grade van der Waals Te Thin Films”为题发表在知名期刊ACS Publitions 上。
本研究采用的是显微共聚焦拉曼光谱仪(AUT-Nanobase-XperRam S)共聚焦显微拉曼光谱仪系统。
了解更多拉曼光谱仪详情,请访问上海昊量光电的官方网页:
https://www.auniontech.com/three-level-166.html
更多详情请联系昊量光电/欢迎直接联系昊量光电
关于昊量光电:
上海昊量光电设备有限公司是光电产品专业代理商,产品包括各类激光器、光电调制器、光学测量设备、光学元件等,涉及应用涵盖了材料加工、光通讯、生物医疗、科学研究、国防、量子光学、生物显微、物联传感、激光制造等;可为客户提供完整的设备安装,培训,硬件开发,软件开发,系统集成等服务。
您可以通过我们昊量光电的官方网站www.auniontech.com了解更多的产品信息,或直接来电咨询4006-888-532。