

方脉冲热源法(Square-Pulsed Source method, SPS)适用于亚毫米级样品的综合热物性测量,能够同时测量各向同性材料的热导率和比热容、三维各向异性热导率张量,以及半导体异质结构的薄膜热导率、比热容和界面热阻。

方脉冲热源法测量系统(SPS)主要应用:
亚毫米级样品的综合热物性测量
同时测量各向同性材料的热导率和比热容
三维各向异性热导率张量
半导体异质结构的薄膜热导率、比热容和界面热阻
同时在时间域和频率域上测量
同时测量热导率和比热容
表征三维各向异性热导率张量
测量操作灵活简便
在微米及更小尺度下,材料的热传导和能量传递机制发生显著变化,尤其是热导率、比热容和界面热阻等热物性参数的变化,这对新材料的热管理和性能优化提出了更高的要求。随着薄膜材料和小尺寸组件在微电子、半导体、光电器件及能源领域的广泛应用,精确测量这些材料的热物性变得尤为重要。然而,传统的宏观尺度热物性测量方法难以有效应用于这些微纳米尺度的材料。
基于方脉冲热源法(Square-Pulsed Source method, SPS)的测量系统,利用激光的泵浦-探测热反射技术,不仅能够同时测量微米薄膜和块体材料的热导率和比热容,还能表征三维各向异性热导率张量,测量半导体异质结界面热阻,准确测量纳米薄膜的热导率,甚至实现亚毫米空间分辨的局部对流换热系数测量。这为材料设计、性能优化以及热管理策略的制定提供了更加全面的技术支持。
方脉冲热源法(Square-Pulsed Source method, SPS)采用激光的泵浦-探测技术,待测的样品表面镀有约100 nm厚的金属膜作为温度传感层,泵浦激光经过50%占空比的方波调制后聚焦在样品表面,对其进行周期性加热;探测激光一部分作为参考信号直接进入平衡光电探测器,另一部分聚焦在样品表面加热样品和探测表面温度。在温升低于10 K的情况下,金属膜反射率与温度变化呈线性关系。样品表面金属膜反射激光的光强变化通过光电探测器转换为电信号,并传输给周期波形分析仪(PWA),以获得方波加热周期下样品表面温度变化的幅值响应信号,幅值信号经归一化处理并与传热模型拟合,从而获取样品的热物性参数。
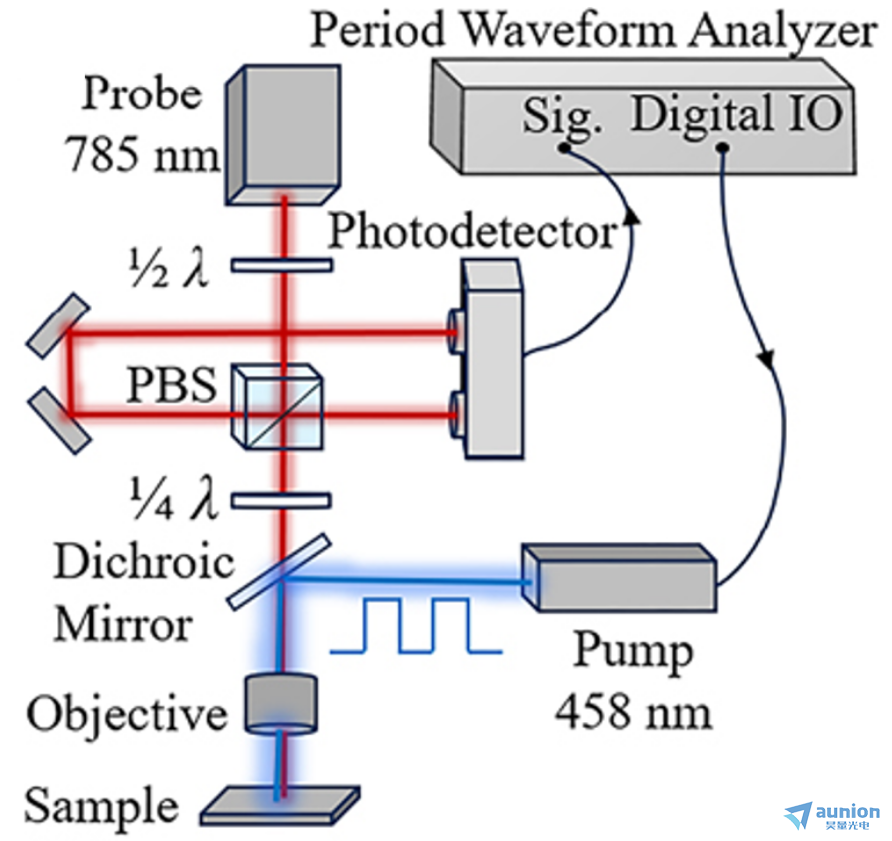
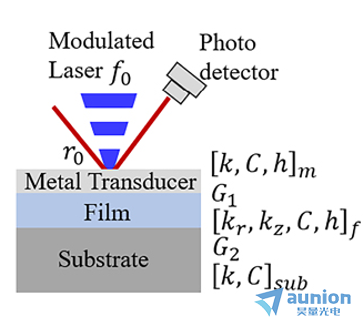
图1 SPS系统原理图和样品结构示意图
1.可同时实现方脉冲热源法(SPS)、空间域热反射法(SDTR)、稳态热反射法(SSTR)的测量
2.双色泵浦-探测系统,标配的泵浦光波长458nm,功率200 mW,探测光波长为785nm
3.泵浦光调制频率的范围为:1Hz-20 MHz
4.光斑半径可变范围:1-40 um
5.ccd显微成像系统清楚观察样品表面和光斑位
6.自动化实验测量,全程软件操作,无需复杂的手动调节
7.自动化信号分析处理,可同时拟合多组信号获取多个参数,并计算测量误差
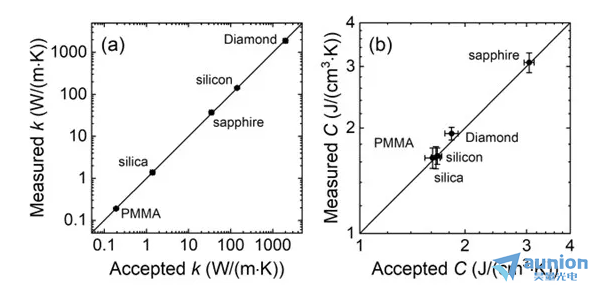
图2. SPS技术对一系列标准样品的热导率和比热容的测量结果与文献参考值的比较
关于昊量光电:
上海昊量光电设备有限公司是光电产品专业代理商,产品包括各类激光器、光电调制器、光学测量设备、光学元件等,涉及应用涵盖了材料加工、光通讯、生物医疗、科学研究、国防、量子光学、生物显微、物联传感、激光制造等;可为客户提供完整的设备安装,培训,硬件开发,软件开发,系统集成等服务。
您可以通过我们昊量光电的官方网站www.auniontech.com了解更多的产品信息,或直接来电咨询4006-888-532。
产品标签:热物性测量,热导率,方脉冲热源法,薄膜热导率,比热容和界面热阻,SPS,亚毫米级样品的综合热物性测量